
龙8手机游戏官网:原位掺杂、扩散和离子注入的相关原理及其区别介绍
发布时间:2024-01-06 13:36 来源:龙8手机版网页登录官网 作者:龙8官方网手机
原位掺杂是半导体材料掺杂的最有效方法是在材料生长过程中进行。在材料的高温生长过程中杂质进入对晶体结构并没有损伤,而且杂质同时被激活,避免了后期的退火工艺和大的热预算。只有完整覆盖的薄膜材料比较容易使用这种方法。
硅烷(SiH4)是最常用的反应气体,二氯甲硅烷(SiH2Cl2)和四氯化硅(SiCl4)偶尔也被使用。在硅片表面,硅烷分解成硅原子和氢气。
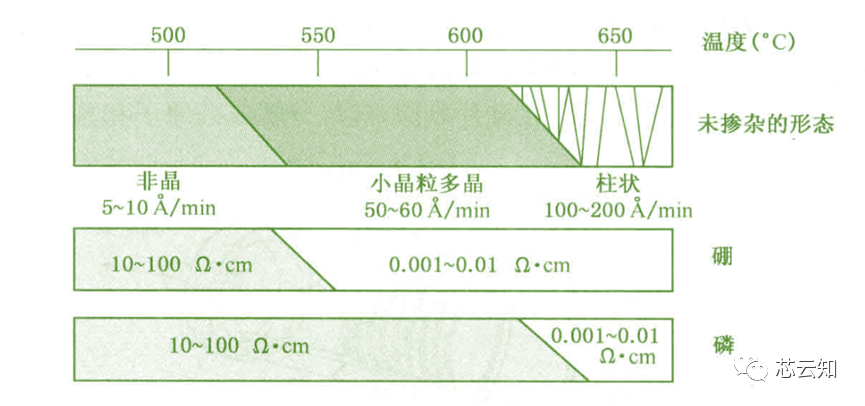
在化学气相淀积过程中,通过在反应物质流中加入合适的杂质源气体,就可以在多晶硅生长的过程中进行原位掺杂。三氯氧化磷(POCl3)是液态材料但可以采用惰性气体以蒸气的方式携带进入反应装置,它被作为CVD系统中的磷杂质源。乙硼烷(B2H6)砷化三氢(AsH3)以及磷化氢(PH3)都是气态材料可被引入反应装置分别作为硼、砷和磷的杂质源。通常杂质流只占硅烷的百分之几,为了安全起见还经常对杂质气源进行稀释(例如,用氮气将PH3稀释到2%)。
在半导体和MEMS技术领域,扩散工艺主要是对于整个薄膜掺杂或对于局部掺杂形成所需的掺杂区。该工艺主要利用高温下杂质由高浓度区向低浓度区的热扩散实现,硅材料的工艺温度通常大于900°C。
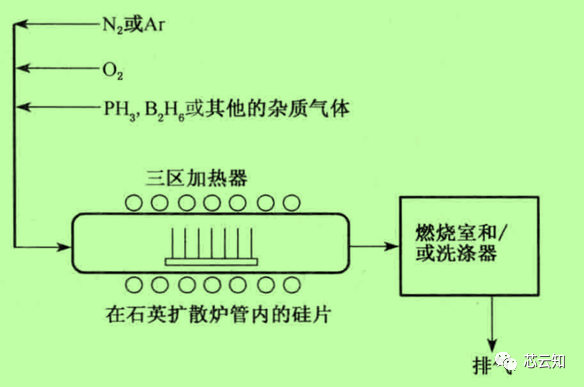
气相扩散:在早期的半导体技术中,气相扩散工艺被广泛地应用,但现在已经很少了,原因是这个工艺需要使用有毒气体。杂质原子由适当的气体携带,例如磷化氢、乙硼烷POCl3、BCl3等, 通入有衬底材料的高温扩散炉。
固相扩散:可以利用在待掺杂衬底上制作的薄膜材料作为杂质源,这些薄膜经常是含有硼或磷的玻璃材料。含磷或含硼的玻璃薄膜应用LPCVD设备,采用低压硅烷和掺有少量PH3或B2H6的进行淀积(温度大约为400°C气压为300mTorr)。因为高杂质浓度的玻璃容易吸湿不利于使用,因此含硼或磷的玻璃中典型杂质水平为4~7wt%。
第一步采用恒定表面源扩散的方式,在硅片表面淀积一定数量的杂质原子。由于扩散温度较低,扩散时间较短,杂质原子在硅片表面的扩散深度极浅,如同淀积在表面,通常称为“预淀积”。
第二步是把经预淀积的硅片放入另一扩散炉内加热,使杂质向硅片内部扩散,重新分布,达到所要求的表面浓度和扩散深度。所以,这一步是有限表面源扩散,常称为“再分布”。
离子注入是一种将高能离子射入半导体衬底材料的掺杂工艺。离子注入工艺比传统的高温扩散工艺更为便利。由于掩膜不需要经受高温,因此有多种多样的掩膜材料可以被选择。由于离子注入会引起晶格损伤,所以必须通过热退火工艺修复晶格,同时也能实现杂质原子的激活。

与扩散方法不同,因为直接与杂质源接触,扩散方法中最高的杂质浓度位于表面,而离子注入工艺可以方便地将杂质送到衬底表面以下,易于实现诸如埋沟器件这样的结构。只要能量足够高,离子也能够穿越表面结构。离子注入所提供的对于杂质浓度和杂质分布的独特控制能力是基本扩散工艺所不可能具备的。